|
|||||||||||
|
ความรู้
|
|||||||||||
   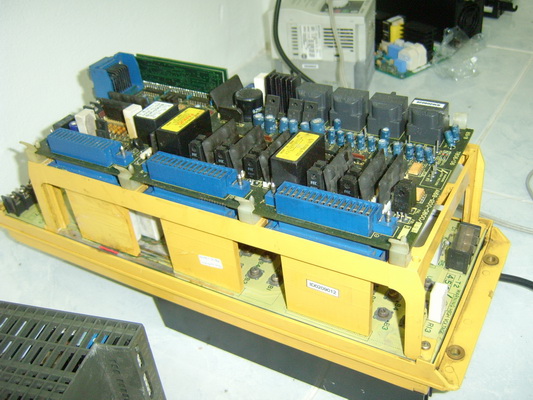     |
|||||||||||
|
1.
Resistor ( ตัวต้านทาน)
|
MOSFET ( มอสเฟต )
มอสเฟทจะแบ่งออกเป็น 2 ชนิด คือ ดีพลีชั่น (Depletion) และ
เอนฮานซ์เมนต์ (Enhancement) ดีมอสเฟทแบบแชนแนล
n 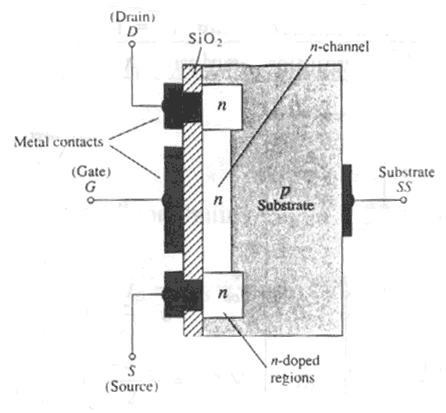
ดีมอสเฟทแบบแชนแนล n ประกอบขึ้นจากแผ่นผลีกฐาน p (p-substrate) ที่เป็นสารกึ่งตัวนำทำจากซิลิกอนขั้ว D และขั้ว S ต่อกับบริเวณที่มีการกระตุ้นหรือโดปให้เป็นบริเวณสารกึ่งตัวนำ n (n-doped region) ทั้งสองส่วนนี้จะเชื่อมกับแชนแนล n สำหรับขั้ว G จะต่อกับวัสดุผิวนอกที่เป็นโลหะโดยมีซิลิคอนไดออกไซด์ (SiO2) กั้นแชนแนล n กับขั้ว G (ซิลิคอนได ออกไซด์เป็นฉนวนประเภทไดอิเลคทริค) เมื่อมีสนามไฟฟ้าจ่ายเข้ามาที่ชั้นของ SiO2 ก็จะสร้างสนามไฟฟ้าต้านและสร้างชั้นฉนวน ขึ้นภายในตัวเองเพื่อกั้นขั้วเกทกับแชนแนล แสดงว่า ไม่มีการต่อโดยตรงระหว่างขั้ว G กับแชนแนลของมอสเฟท ขั้นที่เป็นฉนวน SiO2 จะทำให้ Zi มีค่าสูงตามความต้องการได้ นอกจากนี้บางครั้งจะต่อแผ่นผลึกจากฐานเข้ากับแหล่งจ่ายจึงมีขั้วเพิ่มขึ้นมาเรียกว่า ขั้วผลึกฐาน SS (Substrat : SS) ทำให้มี ขั้วเพิ่มเป็น 4 ขั้ว และจากข้างต้น จึงสรุปความหมายของคำว่า MOS ในชื่อมอสเฟท (ทรานซิสเตอร์สนามไฟฟ้าโลหะออกไซด์สารกึ่งตัวนำ) ได้ดังนี้ - โลหะ (Metal, M) หมายถึง บริเวณสำหรับการต่อขั้ว D, S และ G กับวัสดุผิวนอก - ออกไซด์ (Oxide, O) หมายถึง ซิลิคอนไดออกไซด์ ( SiO2 ) - สารกึ่งตัวนำ (Semiconductor, S) หมายถึง โครงสร้างพื้นฐานในบริเวณแพร่กระจายของสารกึ่งตัวนำชนิด p และสารกึ่ง ตัวนำชนิด n การทำงานและคุณสมบัติเบื้องต้น (Basic Operation and Characteristies) และทำให้กระแส ID = IS = IDSS ไหลผ่านแชนแนล n ได้ (คล้ายกับการไหลของกระแสไฟฟ้าในแชนแนลของเจเฟทขณะ VGS = 0 V) 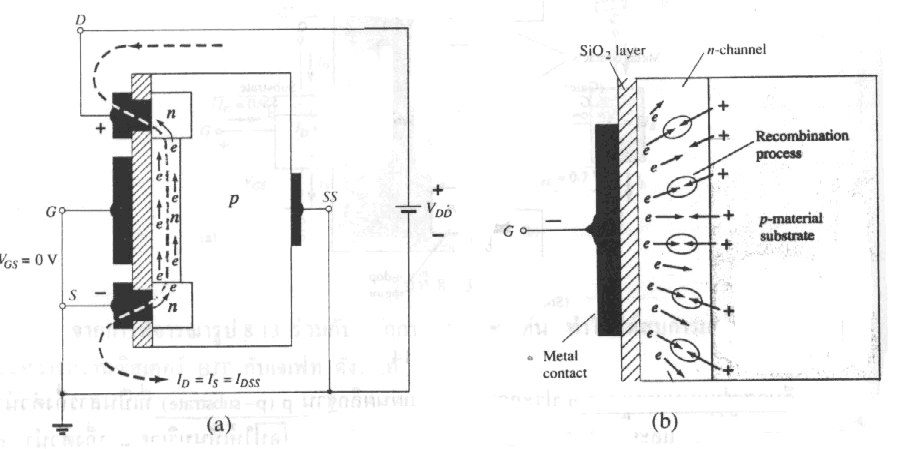

ถ้าจ่าย VGS ที่มีค่าเป็นบวกให้กับขั้วเกทความต่างศักย์ที่ขั้วเกทจะดึงดูดอิเลคตรอนจากผลึกฐาน
p มายังบริเวณชั้น SiO2 ทำให้
ดีมอสเฟทแบบแชนแนล
p 
จากการเปรียบเทียบคุณลักษณะของดีมอสเฟทแบบแชนแนล กับดีมอสเฟทแบบแชนแนล p (ตามรูป b และ c) เราพบว่า ทิศทางของกระแสขั้วแรงดันต่าง ๆ กลับกันทำให้คุณลักษณะกลับกันด้วย ID จะเริ่มเพิ่มขึ้นจากจุด Cutoff ที่ VGS = Vp และขณะที่ VGS มี ค่าเป็นบวกลดลง ID จะเพิ่มขี้นจนถึง IGSS และเพิ่มอย่างต่อเนื่องจนเลยค่า IGSS เมื่อ VGS มีค่าเป็นลบเพิ่มขี้นยังคงใช้สมการของชอคเล่ย์ ได้แต่ ควรระวังเครื่องหมาย VGS และ Vp ในสมการให้ถูกต้อง (คือจะต้องมีเครื่องหมายเป็นบวก)
สัญลักษณ์
(Symbols)

ถ้าสังเกตุให้ดีจะเห็นว่า สัญลักษณ์สื่อความหมายถึงโครงสร้างแท้จริงของอุปกรณ์ ช่องว่างระหว่างขั้ว G กับขั้ว D (ที่ต่อกับขั้ว S) แสดงว่าไม่มีการต่อกันโดยตรงระหว่างขั้วทั้งสามเนื่องจากมีฉนวนกันที่ขั้ว G ส่วนขั้วผลึกฐาน SS ในมอสเฟท บางครั้งมี บางครั้งไม่มี จึงเขียนสัญลักษณ์ได้ทั้ง 2 แบบ คือ กรณีที่มีขั้ว SS และในกรณีไม่มีขั้ว SS ในการวิเคราะห์ลำดับต่อไปมัก จะไม่มีขั้ว SS ดังนั้น สัญลักษณ์ที่อยู่ข้างล่างจะเป็นสัญลักษณ์ที่ใช้ทั่ว ๆ ไป
อีมอสเฟทแบบแชนแนล n 
อีมอสเฟทแบบเชนแนล n ประกอบขึ้นจากแผ่นผลึกฐาน p ที่เป็นสารกึ่งตัวนำทำจากซิลิคอน
ขั้ว D และขั้ว S ต่อกับ
การทำงานและคุณลักษณะเบื้องต้น 
ถ้าจ่าย VDS และVGS ที่มีค่าเป็นบวกดังรูป
ทำให้ขั้ว D และขั้ว G มีความต่างศักย์เป็นบวกการที่ขั้ว G มีความต่างศักย์เป็น

ถ้าเพิ่ม VGS ให้สูงขึ้น ID ก็จะเพิ่มขึ้นด้วย
แต่ถ้า VGS มีค่าคงที่ และ เพิ่มค่า VDS จะทำให้
ID ถึงจุดอิ่มตัว (เช่น เดียวกับดีมอสเฟท) เนื่องจากขั้วบวกของ
VDS ดึงดูดอิเลคตรอน จึงจะทำให้ปลายของช่องทางเหนี่ยวนำบริเวณใกล้ขั้ว
D แคบลง
ถ้ากำหนดให้ VGS = 8 V และ VDS = 2
V ก็จะได้ VDG = -6 V แต่ถ้าเพิ่ม VGS เป็น
5 V ค่า VDG จะเป็น -3 V (ตาม สมการที่ 2 ทำให้ทราบว่า เมื่อ VT คงที่และ VGS ยิ่งสูงขึ้นเท่าใด VDSsat ก็ยิ่งสูงขึ้นเท่านั้น ในรูป (b) ขณะที่ VT เป็น 2 V ณ ตำแหน่งนี้ ID = 0 mA ดังนั้นจึงทำให้ทราบว่า ถ้า VGS มีค่าต่ำกว่า VT ค่า ID ของ อีมอสเฟทจะเป็นศูนย์หรือไม่มีกระแสไหลนั่นเอง ถ้าค่า VGS เพิ่มขึ้นจาก VT เป็น 8 V จะทำให้ระดับการอิ่มตัวของ ID เพิ่มขึ้นจาก 0 mA เป็น 10 mA แต่เนื่องจากช่วง ของเคอร์ฟ VGS มีระยะห่างไม่เท่ากัน ดังนั้น ID ที่เพิ่มขึ้น จึงมีความสัมพันธ์กับ VGS ในลักษณะไม่เป็นเชิงเส้นดังสมการต่อไปนี้
เมื่อ k เป็นค่าคงที่ของโครงสร้างอีมอสเฟท ซึ่งหาค่าได้จาก k = ID(on) / ( VGS(on) - VT )2 --------------------สมการที่ 4 เมื่อ ID(on) และ VGS(on) เป็นกระแสและแรงดันที่ทำให้เกิดจุดเฉพาะบนเคอร์ฟคุณลักษณะของมอสเฟท สมมติแทนค่า ID(on) = 10 mA ขณะ VGS = 8 V ลงในสมการที่ 4 จะได้ k = 0.278 * 10-3 A/V2 แทนค่า k ในสมการที่ 3 เพื่อหาค่า ID สำหรับคุณลักษณะในรูป (b) โดยสมมติ VGS = 4 V จะได้ ID = 1.11 mA สำหรับการวิเคราะห์ไฟฟ้ากระแสตรงของอีมอสเฟท จะใช้คุณลักษณะถ่ายโอนดังรูปต่อไปนี้ในการแก้ปัญหา

เคอร์ฟถ่ายโอนในรูป แตกต่างจากเคอร์ฟถ่ายโอนที่กล่าวในตอนต้น ๆ เพราะว่าอีมอสเฟทแบบแชนแนล n จะมี ID เพิ่มขึ้นไม่ได้จนกว่า VGS = VT สมมติว่าเราจะเขียนเคอร์ฟถ่ายโอนที่มี k = 0.5*10-3 A/V2 และ VT = 4 V เมื่อนำสมการที่ 3 มาร่วม พิจารณา จะได้ อีมอสเฟทแบบแชนแนล p โครงสร้างของอีมอสเฟทแบบแชนแนล p มีลักษณะตรงข้ามกับแบบแชนแนล p
กล่าวคือ ขั้ว D และขั้ว S ต่อกับผลึกฐาน n และบริเวณที่มีการกระตุ้น
p(p-doped regions) แต่ขั้วของแรงดันและทิศทาง

จะเห็นได้ว่าสัญลักษณ์แสดงโครงสร้างแท้จริงของอุปกรณ์เส้นประเชื่อมระหว่างขั้ว
D กับ ขั้ว S แสดงว่าไม่มี |
||
หน้าแรก
| บริการ |
เงื่อนไขการซ่อม | ความรู้
| ติดต่อเรา
Copyright © 2009 All rights reserved. Contact: pp-service@hotmail.com




